
김성일 (Kim S.I.) RF융합부품연구실 선임연구원
민병규 (Min B.G.) RF융합부품연구실 책임연구원
임종원 (Lim J.W.) RF융합부품연구실 실장
권용환 (Kwon Y.H.) 광무선융합부품연구부 부장
남은수 (Nam E.S.) 정보통신부품소재연구소 소장
I. 서론
레이더는 전자파를 대상물을 향해 발사해 그 반사파를 측정하는 것으로써, 대상물까지의 거리나 형상을 측정하는 장치이다. 이러한 레이더는 항공기, 선박, 기상 등 군수 및 민수분야에서 다양하게 사용되고 있다.
기존 레이더 시스템은 진행파관(Traveling Wave Tube), 마그네트론(Magnetron), 클라이스트론(Klyst-ron)과 같은 진공관 형태의 단일 소자에 매우 높은 전압을 인가하여 구동시킨다. 이러한 기존 레이더 시스템은 고출력 특성에도 불구하고 진공관을 사용함으로 인하여 부피가 크고 수명이 짧다. 진공관을 사용한 레이더 시스템의 단점을 보완하기 위하여 해외의 여러 기관 및 선진업체에서는 국가차원의 지원을 받아 반도체 고출력 전력증폭기(SSPA: Solid-State Power Amplifier) 기술을 연구개발해 오고 있다.
반도체 고출력 전력증폭기는 수명시간, 유지보수 및 증폭기 동작 관점에서 우수한 장점을 가지고 있을 뿐만 아니라, 전력증폭기가 완전한 출력 전력 하에 전송을 시작하고 종료할 때, 반도체 고출력 전력증폭기의 승온시간(heat-up time)과 냉각시간(cool-down time)이 진행파관의 승온시간과 냉각시간보다 훨씬 짧기 때문에, 반도체 고출력 전력증폭기가 진행파관을 대체할 것으로 강하게 전망하고 있다[1]. 이외에도 반도체 고출력 전력증폭기는 광대역 주파수 구현, 디지털 신호처리 등의 장점이 있다.
반도체 고출력 전력증폭기(SSPA) 기술은 반도체 전력증폭 소자 및 패키지 기술, 반도체 전력증폭기 모듈 및 MMIC(Microwave Monolithic Integrated Circuit) 기술을 포함한다. 반도체 고출력 전력증폭기 확보를 위하여는 상기의 기술들을 대부분 갖추어야 하며, 이 중 반도체 전력증폭 소자 기술의 보유는 필수이다. 특히 군수와 관련된 반도체 전력증폭 소자는 수출 규제(Export License) 품목으로 지정되어 있어 수입이 불가능하거나 제한적으로 소량만 구매가 가능한 실정이다.
반도체 고출력 증폭기 구현을 위해 기본적으로 갖추어야 할 반도체 전력증폭 소자 기술은 실리콘 기반의 LDMOS(Laterally Diffused Metal Oxide Semiconductor) 소자, 갈륨비소(GaAs: Gallium Arsenide) 기반의 HEMT(High Electron Mobility Transistor) 소자, 질화갈륨(GaN: Gallium Nitride) 기반의 HEMT 소자 기술이 있다. 이 중 GaN 기반의 HEMT 소자(GaN HEMT 소자) 기술은 GaN 재료로 구현되는데, GaN 재료는 3.4eV의 넓은 에너지 갭으로 인하여 고전압에서 동작이 가능하고, 분극전하를 이용한 캐리어 농도가 GaAs의 10배 이상이므로 높은 전류밀도와 높은 전력밀도를 얻을 수 있어 고출력·고효율·소형의 전력증폭기 소자로 적합하다.
반도체 고출력 증폭기는 개별 반도체 전력증폭기 소자를 어레이(array) 및 결합하여 구현되거나, 반도체 기판 상에서 능동소자와 수동소자를 동시에 사용하여 MMIC 형태로 구현되거나, 전력증폭기 MMIC를 어레이 및 결합하여 구현될 수 있다.
최근 군과 관련된 기술을 민간기술로 접목하고 공유하려는 경향이 증가하고 있다. 이러한 민군협력 기술은 여러 분야에서 추진되고 있으며, 레이더 관련 기술이 그 중 하나이다. 특히 레이터와 관련된 송수신(transceiver) 모듈은 군수와 민수기술을 공유할 수 있어 민군 협력 기술의 대표적이라고 할 수 있다. 민군 협력의 레이더 관련 기술은 L-대역, S-대역, X-대역, Ku-대역, Ka-대역 등에서 적용되고 있으며, 이들 대역에서는 대공방어, 항공기 및 무기탐색, 이동통신, 선박, 기상, 위성통신 및 방송 등 여러 분야에서 송신기 기술을 공유할 수 있다. S-대역 및 X-대역 레이더 송신기와 관련된 반도체 고출력 전력증폭기 기술은 기 발간된 여러 문헌에서 보고되고 있다[2][3].
본고에서는 고주파 영역인 Ku-대역 및 Ka-대역 GaN 고출력 전력증폭기(GaN SSPA) 관련 기술동향을 집중적으로 분석하고자 한다. Ku-대역 및 Ka-대역 GaN SSPA와 관련된 GaN 전력증폭 소자, GaN 전력증폭기 MMIC, GaN SSPA에 대하여, 국내외 특허 기술동향과 연구개발 기술동향을 중심으로 기술하고자 한다.
II. GaN 반도체 및 응용
<표 1>[4][5]은 Si(Silicon), GaAs, 4H-SiC(Silicon Carbide) 및 GaN의 반도체 재료에 대한 재료적 성질을 비교한 것이다. GaN의 반도체 재료의 특징은 Si, GaAs, 4H-SiC 반도체 재료들에 비하여 밴드 갭과 항복전계가 크며, 포화속도와 전자 이동도가 대체적으로 크고, 열전도 특성이 우수하다. (그림 1)[6]은 반도체 재료와 소자에 따른 성능지수를 나타내는 것으로, GaN HEMT 소자는 Johnson 성능지수와 Keyes 성능지수, 성능 파라미터 대부분이 높은 영역에 위치해 있다.
GaN HEMT 소자가 고주파 반도체 전력증폭 소자로 적합한 이유는 다음과 같다. 먼저, 높은 전자 이동도와 높은 포화 속도로부터 고속 동작이 가능하고, 높은 항복 전계로부터 높은 드레인 전압에서 동작할 수 있다. GaN HEMT 소자는 SiC 기판, GaN 기판, 사파이어 기판 상에 GaN 채널층을 성장하여 HEMT 소자를 만들 수 있는데, SiC 기판상에 GaN 채널층을 성장하여 HEMT 소자를 만드는 경우는 우수한 열전도 특성을 갖는 SiC 반도체 재료의 장점을 이용할 수 있다[4]. 또한, GaN는 캐리어 농도가 GaAs의 10배 이상 높아 높은 전류밀도와 높은 전력밀도를 낼 수 있어, GaN HEMT 소자는 적은 수를 사용하여 큰 전력을 얻을 수 있고 따라서 소형의 고주파 전력증폭기를 구현할 수 있다.
GaN HEMT 소자는 민수와 군수의 넓은 영역에서 사용될 수 있다. (그림 2)는 GaN HEMT 소자의 응용분야를 나타낸 것으로써[7][8], 군수, 무선통신, 위성통신, 선박 등 민수와 군수의 여러 분야에서 사용될 수 있고 특히 레이더는 큰 출력이 필요함을 알 수 있다.
2010년 Strategy Analytics사에 의해 발표된 시장예측 자료[9]에 의하면, 군수분야가 2014년 전체 GaN 소자 시장에서 군수분야가 46%를 차지할 것으로 예측하고, 민수시장분야는 무선통신망에 사용되는 전력증폭기 요구에 의해 주도되어 성장하고, 자동차용 스위칭 소자와 같은 고출력을 요구하는 전력소자 분야에는 GaN와 경쟁관계에 있는 SiC 기술에 의해 초기 성장이 제한되었다고 보고하였다. 현재 군수분야가 많은 점유율을 갖고 있으나 민수분야의 활용도가 증가함에 따라 앞으로 민수시장의 점유율은 한층 증가할 것으로 예상된다.
III. Ku-대역 GaN 고출력 전력증폭기 기술
본 장에서는 Ku-대역 반도체 고출력 전력증폭기 기술에 대하여 특허 기술동향과 연구개발 기술동향에 대하여 기술하고자 한다.
1. 국내외 특허 기술동향
본 절에서는 Ku-대역 GaN 고출력 전력증폭기 동향은 특허청 주관의 ‘GaN 트랜지스터 기반의 Ku-Band 고출력 증폭기 개발 과제(산업통상자원부 및 방위사업청 민군겸용기술 사업) 특허기술동향조사 보고서[10]’의 내용을 발췌하여 정리하였다. Ku-대역 반도체 고출력 전력증폭기 관련 특허 기술동향은 소자 및 칩(에피택시, GaN TR(Transistor)), 모듈 및 증폭기(패키징, 내부정합, 증폭기)로 분류하여 조사되었다. 다음은 특허 기술동향 조사 보고서[10]의 주요 내용이다.
Ku-대역 GaN 고출력 전력증폭기 관련 특허는 1980년대 중후반부터 출원되어, 1990년대에는 미비한 출원을 보이다가 2000년대 중반에 급격한 출원 증가를 보이고 있고, 특히 2006년에 가장 높은 출원 증가세를 보이고 있는 것으로 나타났다. 대다수의 특허가 2000년대 중후반에 출원되었고, 최근까지 관련 기술의 특허출원이 꾸준히 나타나고 있는 원인으로는 유도무기 탐색기용 송신기, 항공기 및 해상용 레이더 송신기 등의 군사용뿐 아닌 선박용 레이더, 위성통신용 지상송신기, 무궁화위성(VSat)과 같은 민간분야에서 고출력 증폭기에 대한 수요가 증가하고 있기 때문인 것으로 추측된다.
국가별로 살펴보면, 미국의 경우 2000년대 초반 급격한 출원 증가 이후 지속적인 출원 증가세를 보이고 있고, 유럽, 일본 및 한국은 전체 연도별 특허동향과 유사하게 2000년대 중반부터 급격한 출원 증가세를 보이고 있다.
미국의 Cree사가 제1출원인으로 나타났으며, 그 뒤를 이어 일본의 Sumitomo Electric사, Fujitsu사, NGK Insulators사, Toshiba사, Hitachi Cable사 등이 본 기술분야에 있어서 다수의 특허출원을 하고 있는 것으로 조사되었으며, 최근 5년간의 특허출원 증가율을 비교 분석한 결과, 주요 출원인들의 주요 시장국에서 활발한 특허활동을 하고 있는 것으로 나타났다.
현재까지 주요 출원인들은 대부분 에피택시 및 GaN TR과 같은 소자 및 칩 기술에 주력을 하고 있는 것으로 나타났고, 향후 개발된 소자 및 칩 기술을 기반으로 증폭기 제조기술에 주력할 것으로 예상된다.
Ku-대역 반도체 고출력 전력증폭기 관련 세부 기술별 핵심과제는 다음과 같다. 에피택시 기술의 주요 과제는 고주파 디바이스용 에피텍셜 웨이퍼를 제조할 때의 비틀림 저감 및 시트 저항의 분균일을 감소시키는 것이 핵심 과제인 것으로 나타났으며, GaN TR 기술의 주요 과제는 증폭 특성이 개선된 고전자 이동도 트랜지스터를 제조할 시, 애벌런치 항복이 발생하는 것을 방지하고, 전하 트래핑 효과를 저감시켜 전류의 급격한 증가를 방지하는 것이 핵심 과제인 것으로 조사되었다. 패키징 기술의 경우 질화갈륨계 반도체와 금속기판을 안정적으로 접합하는 과제와 발생되는 열을 안전하고 용이하게 방출시키는 과제가 주요 과제인 것으로 나타났고, 특히, 열의 배출을 효과적으로 하는 것이 핵심 과제인 것으로 나타났다. 내부정합 기술은 전기적 출력 특성을 개선하고, 발열문제를 해결하는 과제가 주요 과제인 것으로 나타났다. 증폭기 기술은 전력소모를 최소화하면서 높은 주파수에서 동작이 가능한 증폭기를 제조하는 기술이 핵심 과제인 것으로 나타났다.
앞의 참고문헌 [10]의 요약과 같이, Ku-대역 GaN 고출력 전력증폭기 관련 특허 기술동향 조사 결과, GaN 에피택시와 TR은 에피 및 소자의 신뢰성을 개선하는 방향으로, 모듈 및 증폭기는 발열문제를 해결하고 높은 주파수에서 동작하는 방향으로 핵심특허출원이 이루어지는 것을 알 수 있었다.
2. 국내외 연구개발 기술동향
본 절에서는 Ku-대역 GaN 고출력 전력증폭기 관련 연구개발 동향을 GaN 전력증폭 소자 기술에서부터 GaN 고출력 전력증폭기 기술에 이르기까지, 기 발표된 연구개발 결과를 중심으로 고찰한다.
먼저, Ku-대역 GaN HEMT 소자 연구개발 결과를 소개한다. 일본의 Toshiba사는 게이트 길이 0.4㎛공정의 AlGaN(Aluminum Gallium Nitride)/GaN HEMT 소자를 개발하여 2007년과 2009년에 각각 발표하였다[11][12]. 2007년에 발표한 AlGaN/GaN HEMT 소자는 14.25GHz에서 1.45W/mm의 전력밀도와 15%의 전력부가효율(PAE: Power-Added Efficiency)의 특성을 나타내었으나, 2009년에 발표한 AlGaN/GaN HEMT 소자는 14GHz에서 2.21W/mm의 전력밀도와 33.2%의 전력부가효율의 특성을 나타냈는데, 이는 2007년 발표한 소자에 없었던 후면 via-hole 공정의 도입으로 얻은 결과이다. 프랑스의 Alcatel-Thales III-V Lab에서는 AlGaN/GaN HEMT와 InAlN(Indium Aluminum Nitride)/GaN HEMT를 개발하였다[13]. 18GHz에서 AlGaN/GaN HEMT 소자는 3.1W/mm의 전력밀도와 33.7%의 전력부가효율의 특성을 나타내며, InAlN/GaN HEMT 소자는 4.28W/mm의 전력밀도와 42.7%의 전력부가효율의 특성을 나타낸다. InAlN/GaN HEMT 소자가 전력부가효율이 높은 것은 AlGaN/GaN HEMT 소자의 2DEG(2-Dimensional Electron Gas) 농도가 2.5×1013/cm2에 비하여 InAlN /GaN HEMT 소자의 2DEG 농도가 4 x 1013/cm2로 높아 In의 조성을 17%로 낮출 수 있었기 때문이다[13][14]. 일본의 Fujitsu사는 게이트 길이 0.3㎛ 공정의 AlGaN/GaN HEMT 소자를 개발하였다[15]. AlGaN/AlN(Aluminum Nitride)/GaN/AlN 구조를 사용한 것과 후면 via-hole 공정을 도입하였다는 것이 특징이다. 13.9GHz에서 4.45W/mm의 전력밀도와 36.4%의 전력부가효율의 특성을 갖는다. 일본의 Renesas Electronics사에서는 고저항 실리콘기판 상에 T-게이트 구조의 GaN HFET를 개발하였는데[16], 항복전압을 높이기 위하여 AlGaN/GaN 채널층 아래에 AlGaN 버퍼층을 사용하였다. 14GHz에서 AlGaN/GaN HFET 소자는 3.82W/mm의 전력밀도와 24.3%의 전력부가효율의 특성을 나타낸다. <표 2>에 Ku-대역 GaN HEMT 전력증폭 소자 기술을 비교 요약하였다.
다음은 Ku-대역 GaN 전력증폭기 MMIC 연구개발 결과를 소개한다. Fujitsu사는 0.25㎛ GaN HEMT 공정을 사용하여 6~18GHz의 광대역 GaN 전력증폭기 MMIC를 개발하였는데[17], 전력이득이 4.5dB, 출력전력이 12.9W, 전력부가효율이 18%이다. 프랑스의 UMS사는 0.25㎛ GaN HEMT 공정을 사용하여 6~18 GHz의 광대역 GaN 전력증폭기 MMIC를 개발하였는데[18], 전력이득이 16.6dB, 출력전력이 7.7W, 전력부가효율이 17.6%이다. 미국의 BAE Systems Electronic Solu-tions는 0.2㎛ GaN HEMT 공정을 사용하여 2~20 GHz의 광대역 GaN 전력증폭기 MMIC를 개발하였는데[19], 전력이득이 9.7dB, 출력전력이 16W, 전력부가효율이 25.9%이다. 일본의 Mitsubishi사는 0.25㎛ GaN HEMT 공정을 사용하여 6~18GHz의 광대역 GaN 전력증폭기 MMIC를 개발하였는데[20], 전력이득이 9.6dB, 출력전력이 20W, 전력부가효율이 15%이다. <표 3>에 Ku-대역 GaN 전력증폭기 MMIC 기술 비교를 하였다.
다음은 Ku-대역 내부정합 패키지형 GaN 전력증폭기와 GaN 고출력 전력증폭기(GaN SSPA) 연구개발 결과를 소개한다. Mitsubishi사는 0.25㎛ GaN HEMT 공정을 사용하여 Ku-대역 내부정합형 패키지 GaN 전력증폭기를 고효율용과 고출력용 두 가지 형태로 개발하였는데[1][21][22], 고효율용은 62.2W의 출력전압에 44.9%의 전력부가효율 특성을 나타내고 있으며[1] 고출력용은 80W의 출력전력에 22%의 전력부가효율[22]과 100W의 출력전력[21]을 나타낸다. GaN SSPA는 Toshiba사에서 발표하였는데[23], 출력전력 120W와 전력부가효율 9% 이상의 성능을 나타낸다. <표 4>에 Ku-대역 내부정합 패키지형 GaN 전력증폭기 및 GaN 고출력 전력증폭기 기술을 비교를 하였다.
상기에서 고찰한 바와 같이, Ku-대역 GaN 고출력 전력증폭기 관련 연구는 미국, 유럽, 일본을 중심으로 GaN HEMT 소자 기술에서부터 GaN 고출력 전력증폭기 기술에 이르기까지, 상당한 수준으로 개발이 이루어진 것을 알 수 있다. 대체적으로 0.25㎛급 GaN HEMT 소자 공정에 후면 via-hole 공정을 도입하고 있다. GaN HEMT 소자는 SiC 기판상의 기본 GaN HEMT 소자로부터, 고주파에서 효율을 높이고자 SiC 기판 상에 InAlN/GaN 채널층을 사용하고, 출력전력 밀도를 높이고자 SiC 기판과 채널층 및 채널층 사이에 삽입층을 도입하고 있으며, 저가격의 고주파 전력증폭 소자를 구현하고자 실리콘 기판상에 GaN HEMT를 구현하려는 시도가 있다. Ku-대역 GaN 전력증폭기 MMIC는 GaN HEMT 소자와 MMIC 설계 장점을 최대한 살려 저주파에서부터 Ku-대역까지 광대역으로 구현하려는 경향이 있다. 또한, Ku-대역 GaN 전력증폭기 MMIC 보다 큰 전력을 얻기 위하여 Mitsubishi사를 중심으로 내부정합 패키지형 GaN 전력증폭기가 구현되고 있으며, GaN SSPA도 상당한 수준에 도달해 있음을 알 수 있다.
국내의 경우, Ku-대역 GaN 고출력 전력증폭기 기술동향은 다음과 같다. 한국전자통신연구원에서는 Ku-대역 GaN HEMT 소자와 MMIC 연구를 수행 중이고 ㈜기가레인에서는 내부정합 패키형 GaN 전력증폭기 연구를 수행 중이며, GaN SSPA 개발은 알에프코어㈜를 비롯한 일부 업체 중심으로 이루어지고 있다. (그림 3)은 한국전자통신연구원 개발한 Ku-대역 GaN 전력증폭 소자와 성능을 보여주는 것으로, 주파수 16GHz와 드레인 전압 30V에서 측정한 게이트 길이 0.25㎛ GaN HEMT 소자의 출력전력은 17W이고 전력부가효율은 31%이다. 한편, 한국전자통신연구원에서는 상용 파운드리를 이용하여 Ku-대역 GaN 전력증폭기 MMIC를 개발하였는데, 출력전력은 10W이고 전력부가효율은 25%이다[24].
IV. Ka-대역 GaN 고출력 전력증폭기 기술
본 장에서는 Ka-대역 GaN 고출력 전력증폭기 기술에 대하여 특허 기술동향과 연구개발 기술동향에 대하여 기술하고자 한다.
1. 국내외 특허 기술동향
본 절에서는 Ka-대역 GaN 고출력 전력증폭기 동향은 특허청 주관의 ‘Ka 대역 GaN MMIC 기반 SSPA 개발 과제(산업통상자원부 및 방위사업청 민군겸용기술 사업) 특허기술동향조사 보고서[25]’의 내용을 발췌하여 정리하였다. Ka-대역 GaN 고출력 전력증폭기 관련 특허 기술동향은 소자(GaN 반도체 소자, GaN TR), 모듈(MMIC, SSPA)로 분류하여 조사되었다. 다음은 특허 기술동향 조사 보고서[25]의 주요 내용이다.
Ka-대역 반도체 고출력 전력증폭기 관련 특허는 1990년대 중반부터 출원되어, 1990년대에는 미비한 출원을 보이다가 2000년대 후반에 급격한 출원 증가를 보이고 있고, 특히 2011년에 가장 높은 출원 증가세를 보이고 있는 것으로 나타났다. 대다수의 특허가 2000년대 후반에 출원되었고, 최근까지 관련 기술의 특허출원이 꾸준히 나타나고 있다.
국가별로 살펴보면, 미국의 경우 2000년 들어 관련 특허출원이 증가하기 시작하여 2000 중반 다소 주춤하였기는 하지만 최근까지 특허출원이 계속 증가하는 경향을 보이고 있고, 일본의 경우 2000년 들어 특허출원이 크게 증가하며 큰 폭의 상승세를 나타내다 2009년을 기점으로 점차 감소하는 경향을 나타내고 있다. 유럽의 경우 극히 적은 수의 특허출원이 매년 이루어지고 있으며, 한국의 경우 매년 10건 이내의 적은 특허출원이 큰 변동 없이 출원되고 있는 것으로 조사되었다.
Toshiba사가 제1출원인으로 나타났으며, 그 다음으로 미국의 Cree사인 것으로 나타났다. 주요 출원인의 국적을 살펴보면 미국의 Alcatel Lucent사를 제외한 모든 주요 출원인들이 일본 및 미국 국적의 출원인인 것으로 나타났다. Toshiba사 및 Cree사는 3극 패밀리수도 많으며 최근 5년 특허출원 증가율도 압도적으로 높아 최근 전세계적으로 활발한 특허출원 활동을 벌이고 있는 것으로 조사되었다.
Toshiba사 및 Cree사는 기초 소자분야에 주력하고 있는데 반해, SSPA분야에서는 미국의 Northrop Grum-man사가 활발한 특허출원 활동을 벌이고 있는 것으로 나타났다. GaN TR 핵심특허가 지속적으로 출원되고 있으며 점차 SSPA분야 특허출원이 증가하는 추세인 것으로 판단된다.
Ka-대역 GaN 고출력 전력증폭기 세부 기술별 핵심과제는 다음과 같다. GaN TR 분야의 과제는 응답특성을 개선하거나 고온에서 동작 가능하도록 하는 등 기존 GaN TR 성능 개선 관련 특허출원이 이루어지다가 점차 고주파에서 동작 가능한 GaN TR 관련 특허들의 출원이 이루어지는 것을 볼 수 있다. GaN MMIC 분야의 과제도 최근에는 고주파 대역에서 사용 가능한 MMIC 및 고출력, 고효율화 및 소형화에 따라 발생하는 발열 특성을 개선하기 위한 MMIC 관련 특허들의 출원이 이루어지는 것을 볼 수 있다. SSPA 분야의 과제는 MMIC 기술흐름과 유사하게 최근에는 고주파 대역에서 사용 가능한 SSPA 및 고출력, 고품질이 가능하게 하는 SSPA 관련 특허들의 출원이 이루어지는 것을 살펴볼 수 있다.
앞의 참고문헌 [25]의 요약과 같이, Ka-대역 GaN 고출력 전력증폭기 관련 특허 기술동향 조사 결과, 2000년 이후 본격적으로 특허출원이 이루어지기 시작하였으며 최근까지 계속 증가하는 추세를 나타내고 있음을 알 수 있었다. 또한, 최근에는 고주파 대역에서 사용 가능한 GaN MMIC 및 SSPA 관련기술과 고출력, 고효율화 및 소형화에 따라 발생하는 발열 특성을 개선하기 위한 특허출원이 이루어지는 것을 알 수 있었다.
2. 국내외 연구개발 기술동향
본 절에서는 Ka-대역 GaN 고출력 전력증폭기 관련 연구개발 동향을 GaN HEMT 소자 기술에서부터 GaN 고출력 전력증폭기 기술에 이르기까지, 기 발표된 연구개발 결과를 중심으로 고찰한다.
먼저, Ka-대역 GaN HEMT 소자 연구개발 결과를 소개한다. 미국의 HRL에서는 게이트 길이 0.14㎛ 공정의 AlGaN/GaN HEMT 소자를 개발하였는데[26], AlGaN/GaN HEMT 소자는 33GHz에서 5.0W/mm의 전력밀도와 55%의 전력부가효율의 특성을 나타낸다. 전력밀도와 전력부가효율에서 우수한 특성을 갖는 것은 n+ 소스 컨텍 렛지(source contact ledge)를 사용하여 기생 채널 저항을 50% 정도 감소시킨 것에 기인한다. 중국 난징전자소자연구소(Nanjing Electronic Devices Institute)에서는 게이트 길이 0.15㎛ 공정의 AlGaN/GaN HEMT 소자를 개발하였다[27]. AlGaN/ GaN HEMT 소자는 34GHz에서 3.1W/mm의 전력밀도와 26.3%의 전력부가효율의 특성을 나타낸다. AlGaN/GaN/AlGaN 이중 접합구조를 사용하였으며 Y-모양 게이트를 사용하여 기생 커패시턴스를 효과적으로 감소시켜 ft(Cut-off Frequency)와 fmax(maxi-mum Os-cillation Frequency)를 개선시킨 점이 특징이다. Alcatel-Thales III-V Lab에서는 0.15㎛ 공정의 InAlN/GaN HEMT를 개발하였다[28]. 30GHz에서 InAlN/GaN HEMT 소자는 2.5W/mm의 전력밀도와 25%의 전력부가효율의 특성을 나타내며, Ku-대역 소자와 마찬가지로 AlGaN /GaN 채널층을 InAlN/GaN층으로 사용하여 전력부가효율을 개선하고자 하였다. 프랑스의 IEMN/ CNRS 연구소에서는 실리콘기판 상에 T-게이트 구조의 GaN HEMT 소자를 개발하였는데[29], 초박막 AlN/GaN 장벽(barrier)이 있는 이중 이종접합 구조를 사용하여 고주파 특성 향상을 꾀하였다. <표 5>에 Ka-대역 GaN 전력증폭 소자 기술을 비교 요약하였다. Toshiba사에서는 AlGaN/GaN HEMT 구조를 사용하여 HEMT 소자를 개발하였는데[30], 게이트 폭 600㎛ GaN HEMT의 경우 주파수 28GHz와 드레인 전압 24V에서 출력전격 2.1W, 전력밀도 2.6W/mm와 전력부가효율 28.6%의 특성을 나타낸다.
다음은 Ka-대역 GaN 전력증폭기 MMIC 연구개발 결과를 소개한다. 미국의 TriQuint사는 2012년에 0.15㎛ GaN HEMT 공정을 사용하여 25~29.5GHz의 GaN 전력증폭기 MMIC를 개발하였는데[31], 전력이득이 24dB, 출력전력이 8.7W, 전력부가효율이 26%이다. 또한, 2013년에는 0.15㎛ GaN HEMT 공정을 사용하여 28.5~31.5GHz의 GaN 전력증폭기 MMIC를 개발하였는데[32], 전력이득이 28dB, 출력전력이 11W, 전력부가효율이 30%으로, 현재까지 발표된 것 중 최고의 결과이다. 프랑스의 XLM-UMR/CNRS는 0.15㎛ GaN HEMT 공정을 사용하여 29~31GHz의 GaN 전력증폭기 MMIC를 개발하였는데[33], 전력이득이 14 dB, 출력전력이 4.7W, 전력부가효율이 28%이다. Northrop Grumman사는 0.2㎛ GaN HEMT 공정을 사용하여 27~31GHz의 GaN 전력증폭기 MMIC를 개발하였는데[34], 전력이득이 21dB, 출력전력이 8W, 전력부가효율이 28%이다. <표 6>에 Ka-대역 GaN 전력증폭기 MMIC 기술 비교를 하였다.
Ka-대역 내부정합형 패키지형 GaN 전력증폭기와 GaN 고출력 전력증폭기(GaN SSPA) 연구개발 결과가 논문에 보고된 예는 많지 않다. Toshiba사에서는 내부정합 패키지형 GaN 전력증폭기를 개발하였으며[30], 주파수 26GHz와 드레인 전압 24V에서 출력전력 20W와 전력부가효율 18.5%의 특성을 갖는다. 고출력 전력증폭기(SSPA)는 미국의 Sopia Wireless사를 비롯하여 외국의 일부 업체에서 선보이고 있으며 동작주파수 30GHz에서 20W 정도의 출력을 내는 것으로 알려져 있다.
상기에서 고찰한 바와 같이, Ka-대역 GaN 고출력 전력증폭기 관련 연구는 전력증폭 소자와 전력증폭기 MMIC 위주로 개발이 되고 있다. Ku-대역과 마찬가지로 GaN 전력증폭 소자 기술에서부터 GaN 전력증폭기 MMIC 기술에 이르기까지, 미국, 유럽, 일본을 중심으로 연구개발이 진행되고 있음을 알 수 있다. Ka-대역 GaN HEMT 소자는 대체적으로 0.15㎛급에서 소자 개발이 되고 있다. Ku-대역에 비해, Ka-대역 GaN HEMT 소자 구조는 게이트 길이를 축소하면서 소자구조를 보다 적극적으로 변경하려는 노력을 엿볼 수 있다. 출력전력과 전력부가효율을 개선을 위해 소스 컨텍 렛지를 만들어 기생 채널저항을 줄이거나, 기존의 AlGaN/GaN 채널을 InAlN/GaN 채널로 변경하거나, 이중의 AlGaN/GaN/AlGaN층 구조의 도입이 그것이다. 또한, Ka-대역은 밀리미터파 대역의 높은 주파수 영역이므로, 전력증폭 소자가 이 영역에서 동작할 수 있도록 기존의 T-모양 게이트를 Y-모양 게이트로 변경하여 기생 커패시턴스 줄이고 이의 효과로 ft와 fmax를 개선시키려는 시도가 있다. Ka-대역 GaN 전력증폭기 MMIC 개발도 GaN 전력증폭 소자와 마찬가지로, 미국, 유럽, 일본이 기술을 선도하고 있다. 특히, TriQuint사와 Northrop Grumman사는 Ka-대역 GaN 전력증폭기 MMIC 기술력에서 세계 최고의 그룹을 유지하고 있다. Ka-대역이 밀리미터파 대역에 속해 GaN 전력증폭기 MMIC 전력증폭기 개발이 고출력 전력증폭기(SSPA) 개발보다 더 활발하게 이루어지는 것으로 생각되며, 내부정합 패키지형 GaN 전력증폭기 개발과 더불어 GaN 전력증폭기 MMIC 기술이 성숙 단계에 이르면 SSPA 개발도 지금 보다 더욱 탄력을 받을 것으로 판단된다.
국내의 경우, Ka-대역 GaN 고출력 전력증폭기 기술 동향은 다음과 같다. 한국전자통신연구원에서는 외국의 경우와 마찬가지로 게이트 길이 0.15㎛ GaN 전력증폭 소자를 개발 중이며, 또한 상용 파운드리를 사용하여 GaN 전력증폭기 MMIC를 개발 중에 있다. (그림 4)는 최근 한국전자통신연구원에 개발한 Ka-대역 GaN HEMT 소자와 성능을 보여주는 것으로, 주파수 30GHz와 드레인 전압 20V에서 측정한 게이트 길이 0.15㎛ GaN HEMT 소자의 전력밀도는 1.3W/mm이고 전력부가효율은 31%이다.
V. 결론
본 고에서는 고주파 영역 Ku-대역 및 Ka-대역 GaN 고출력 전력증폭기 관련 기술을 특허동향과 연구개발 동향 중심으로 고찰해 보았다.
GaN HEMT 소자 기술은 Ku-대역과 Ka-대역에서 각각 게이트 길이 0.25㎛급과 0.15㎛급으로 개발되고 있으며, 동시에 후면 via-hole 공정을 도입하고 있다. Ku-대역에서 GaN HEMT 소자 기술은 주로 채널구조 변경과 신뢰성 개선을 통하여 성능개선이 이루어지고 있으며, Ka-대역에서 GaN HEMT 소자 기술은 주로 주파수 향상과 전력효율 개선을 위해 기생성분 감소의 게이트와 소스 구조 변경, 이중 채널구조 채택 등이 시도되고 있다.
GaN 전력증폭기 MMIC 기술은 Ku-대역에서는 광대역으로 구현되고 있으며, Ka-대역에서는 동작주파수 범위 근처에서 동작하도록 개발되고 있다. Ku-대역과 Ka-대역 모두 고주파 고출력에서 동작하므로 방열설계의 필요성을 강조하고 있다.
개별 GaN HEMT 소자나 GaN 전력증폭기 MMIC 보다 큰 전력을 얻기 위하여 내부정합 패키지형 GaN 전력증폭기가 개발되고 있으며, 고출력의 전력증폭기를 구현할 목적으로 SSPA가 개발되고 있다. Ku-대역에서는 내부정합 패키지형 GaN 전력증폭기 개발이 많이 이루어지고 있으며, Ka-대역에서는 내부정합 패키지형 GaN 전력증폭기와 SSPA에 비하여 GaN 전력증폭기 MMIC 개발이 활발하게 이루어지는 것을 알 수 있다. 내부정합 패키지형 GaN 전력증폭기와 GaN SSPA 개발에서도 Ku-대역과 Ka-대역 모두 고주파 고출력에서 동작하므로 방열설계의 필요성을 강조하고 있다.
본고에서 살펴본 바와 같이, Ku-대역 및 Ka-대역 GaN 고출력 전력증폭기 관련하여 미국, 유럽, 일본은 상당한 기술 수준에 도달해 있는 것으로 판단된다. 본고에서의 GaN 고주파 고출력 전력증폭기 기술분석이 국내 연구개발의 촉진제가 되고 연구에 많은 도움을 주었으면 하는 바람이다.
약어 정리
2DEG
2-Dimensional Electron Gas
AlGaN
Aluminum Gallium Nitride
AlN
Aluminum Nitride
fmax
maximum Oscillation Frequency
ft
Cut-off Frequency
GaAs
Gallium Arsenide
GaN
Gallium Nitride
HEMT
High electron Mobility Transistor
HFET
Hetero-junction Field Effect Transistor
InAlN
Indium Aluminum Nitride
LDMOS
Laterally Diffused Metal Oxide Semiconductor
MMIC
Microwave Monolithic Integrated Circuit
PAE
Power-Added Efficiency
Si
Silicon
SiC
Silicon Carbide
SSPA
Solid-State Power Amplifier
TR
Transistor
References
<표 1>

Si, GaAs, SiC 및 GaN 반도체 재료 성질 비교
(그림 1)
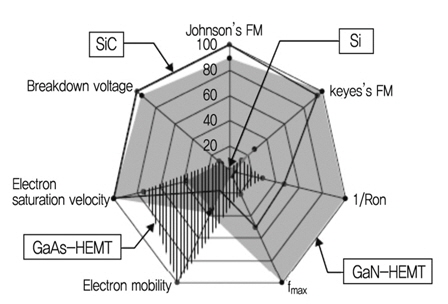
반도체 재료와 소자의 성능지수도<a href="#r006">[6]</a>
(그림 2)
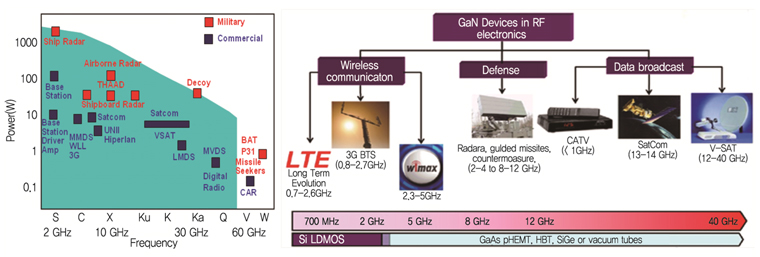
GaN HEMT 소자의 응용분야<a href="#r007">[7]</a><a href="#r008">[8]</a>
<표 2>
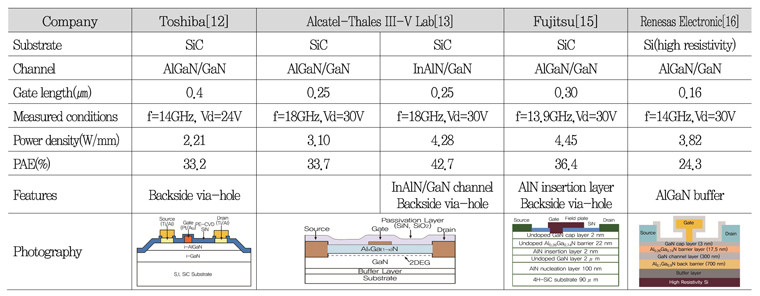
Ku-대역 GaN HEMT 소자 기술 비교
<표 3>
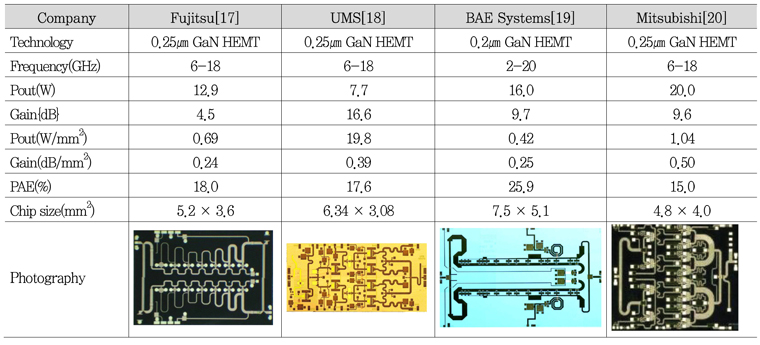
Ku-대역 GaN 전력증폭기 MMIC 기술 비교
<표 4>
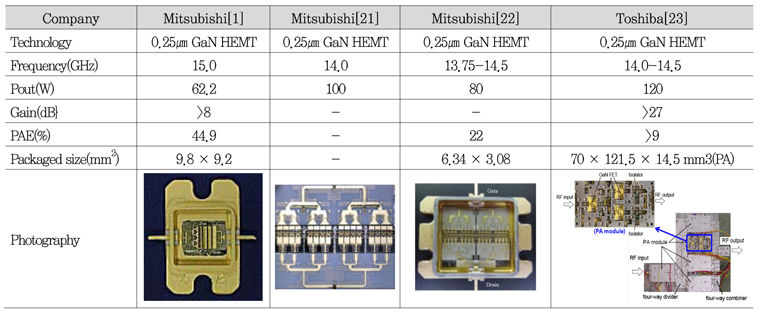
Ku-대역 내부정합 패키지형 GaN 전력증폭기 및 GaN 고출력 전력증폭기(GaN SSPA) 기술 비교
(그림 3)
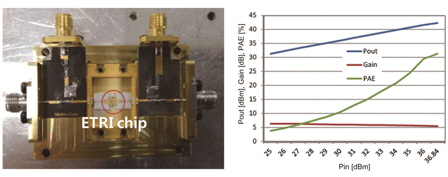
한국전자통신연구원이 개발한 Ku-대역 GaN HEMT 소자 및 성능
<표 5>
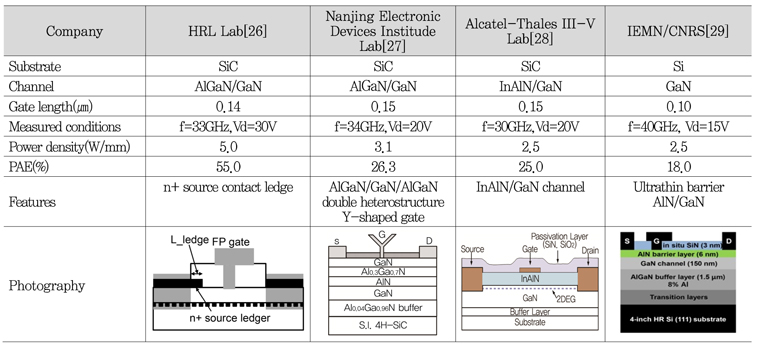
Ka-대역 GaN HEMT 소자 기술 비교
<표 6>
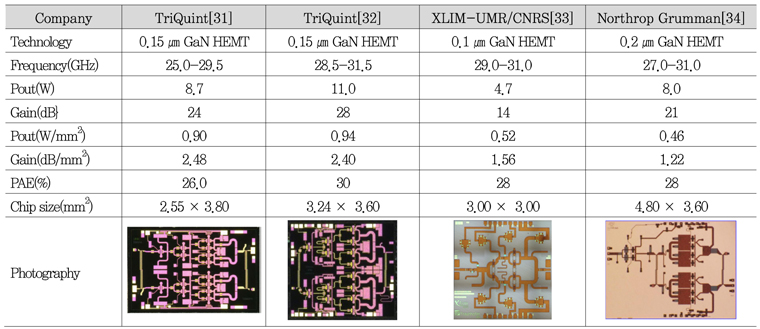
Ka-대역 GaN 전력증폭기 MMIC 기술 비교
(그림 4)
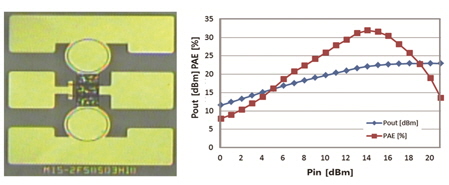
한국전자통신연구원이 개발한 Ka-대역 GaN HEMT 소자 및 성능