원자층 식각 공정 및 장비 지능화 기술 개발
Advanced Intelligent Technologies for Atomic Plasma Etching Processes and Equipment
- 저자
-
윤두협차세대반도체소자연구실 dhyoun@etri.re.kr 박정우차세대반도체소자연구실 pjw21@etri.re.kr 서동우소재부품연구본부 dwsuh@etri.re.kr
- 권호
- 41권 1호 (통권 218)
- 논문구분
- 일반논문
- 페이지
- 60-68
- 발행일자
- 2026.02.02
- DOI
- 10.22648/ETRI.2026.J.410106
 본 저작물은 공공누리 제4유형: 출처표시 + 상업적이용금지 + 변경금지 조건에 따라 이용할 수 있습니다.
본 저작물은 공공누리 제4유형: 출처표시 + 상업적이용금지 + 변경금지 조건에 따라 이용할 수 있습니다.- 초록
- The aim of research that explores intelligent technologies for atomic plasma etching processes and equipment is to optimize the performance of the plasma etching and synthesis tools of etching equipment, maximizing etching velocityand productivity through automation and intelligent synthesis. This involves developing technologies that integrate machine learning, artificial intelligence, sensor technology, and data analysis to enable self-diagnosis, process optimization, prediction, and equipment maintenance. Such research is particularly concerned with enhancing the stability of complex plasma processes and improving etching velocity, key for developing important applications in next-generation semiconductor industries. This review discussesrecent research trends and future development directions in the field of intelligent plasma equipment.
Share
I. 연구 동향
1. Lam Research
반도체 제조 장비 분야에서 선도적인 기업 중 하나로, 특히 플라즈마(Plasma) 원자층 식각 및 화학 기상 증착(CVD: Chemical Vapor Deposition)의 지능화에 특화되어 있다. Lam Research는 제조 공정의 효율성, 정밀도 및 생산성을 향상시키기 위해 지능화 기술, 데이터 분석, 고급 센서 기술 및 인공지능(AI:
Artificial Intelligence)을 적극적으로 활용하고 있는데, 관련 분야에 대한 선행연구사례는 다음과 같다[1-4].
Lam Research는 고도로 정밀한 센서와 실시간 데이터 분석 기능을 통합하여, 반도체 공정 중 발생할 수 있는 미세한 변화를 감지하고 자동으로 조정하는 솔루션을 장비에 탑재하고 있다. 시뮬레이션 기술과 연계하여 엔지니어들에게 특정 공정의 상황을 예측할 수 있는 기능이 제공되고 있다.
머신러닝 및 AI 기반의 분석 도구를 사용하여 공정 데이터를 분석하고, 공정 성능을 최적화하는 기능이 개발되어 장비에 탑재되어 있는데, 특히 서로 다른 공정장비와 설비에 적용 가능한 진단 센서 기술이 특징이라 할 수 있다.
장비 상태 모니터링 및 예측 유지보수: 장비의 성능과 상태를 지속적으로 모니터링하여 장비 고장을 사전에 예측하고, 유지보수를 계획할 수 있는 솔루션을 제공하고 있다.
2. Applied Materials
세계적인 반도체 및 디스플레이 제조 장비 공급업체로, 원자층 식각 장비의 지능화를 포함하여 고도의 기술 혁신을 주도하고 있다. 이 회사는 자동화, 공정 제어, 센서 기술, 데이터 분석 및 AI를 활용하여 장비의 성능을 향상시키고, 제조 공정의 효율성과 생산성을 극대화하는 다양한 사례를 제공하고 있는데, 간략하게 정리하면 다음과 같다[4].
AI 기반 예측 유지보수: AI와 머신러닝 모델을 활용하여 장비의 상태를 실시간 모니터링하고, 잠재적인 고장을 사전에 예측하는 기술을 장비에 내재화하였다. 이를 통해, 예기치 않은 장비 고장과 생산 중단을 최소화하는 기능을 제공하고 있다. AIx(Actionable Insight Accelerator) 플랫폼은 Applied Materials 가 제공하는 장비 데이터 분석 및 공정 최적화 플랫폼이다. 이 솔루션은 장비 데이터를 수집하고 분석하여, 공정 개선점을 식별하고, 생산성을 향상시킬 수 있는 인사이트를 장비 엔지니어에게 제공하는 데 중요한 역할을 하고 있다.
3. 플라즈마 지능화 연구단
국내 주요 장비사의 경우 일찍부터 지능화 관련 연구를 진행해 오고 있으며, 장비 차원에서 공정을 모니터링하고 결함을 발견하기 위한 기술에 초점을 두고 기술 개발 및 장비 내재화를 추진하고 있다. 플라즈마 공정 장비의 지능화 관련 기업 실증을 통해 국내 장비 기술의 경쟁력 강화에 기여하고자 4개의 정부출연연구소와 10여 개의 대학이 참여하고 있다.
센서, 데이터 분석 및 공정 예측을 위한 시뮬레이션 기반의 AI/ML(Machine Learning) 기술 등을 개발하고 있으며, 주요 장비사나 부품사에 기술을 적용하여 실증을 진행해 오고 있다. 비접촉식 광학적‧전자기적 진단으로 플라즈마 공정 및 장비 지능화 기술을 개발하고, 시뮬레이션 및 AI/ML 기술을 접목하여 공정 및 장비에 장착된 센서의 성능을 높이고 추가적인 정보 제공이 가능하도록 만드는 것을 목표로 개발 중이다. 플라즈마 및 공정 결과에 대한 측정 데이터를 바탕으로 센서를 지능화하고, 지능화된 센서가 공정-결과를 예측할 수 있도록 시뮬레이션 기술과 연계시키는 연구를 진행 중이다.
4. ETRI 지능화 연구
기존 극저전력 CFET 적용을 위한 원자층 제어 기술(ALD: Atomic Layer Deposition/ALE: Atomic Layer Etching) 개발, 인공지능 학습 적용 원자층 증착/식각 공정 및 장비 지능화 연구, 차세대 반도체 공정 및 장비 지능화를 목표로 다음과 같은 연구를 진행 중이다.
4.1 ALE 공정의 에칭-종점 감지 지능화
ALE(원자층 식각) 종말점 검출(End-Point Detection) 지능화(그림 1)는 여러 센서에서 확보한 데이터를 통합하고 AI를 활용해 원자층 단위의 미세한 식각 공정을 정확하게 제어하는 기술이다[5,6]. 칩의 고집적화와 3D 구조가 복잡해지면서 기존의 단일 신호 기반 종말점 검출 방식의 한계를 극복하기 위한 핵심 기술이다.
4.2 센서 기반 다중 신호 통합
ALE(원자층 식각) 공정은 한 사이클에 원자층 한 두 개만 식각하므로, 공정 종말점에서 나타나는 물리적‧화학적 신호 변화가 매우 미미하고, 식각 목표물이 있는 홀(Hole)의 면적이 전체 웨이퍼 면적에서 매우 작아서, 종말점 검출에 필요한 신호 대 잡음-비(SNR: Signal to Noise Ratio)가 낮아지고, 또한 여러 종류의 재료로 구성된 복합 구조물을 식각할 때 재료별 특성이 달라 종말점을 정확하게 구분하기 어려워 종말점을 검출하기가 어렵다.
이러한 어려움을 극복하기 위해서는 공정 중 실시간으로 그림 2에 도시한 센서-데이터를 활용하고, 멀티 센서 데이터를 통합 분석하여 공정 종료 시점을 예측하는 멀티모달 신호 융합(Sensor Fusion)과 노이즈에 강한 알고리즘 개발로 신호 패턴의 변화를 감지하는 기술을 연구 중이다.
그림 2
각종 센서의 측정 기능 및 공정 흐름도[4]
출처 Reprinted with permission from 윤정식, “플라즈마장비 지능화기술,” Vacuum Magazine, 2024. 3.
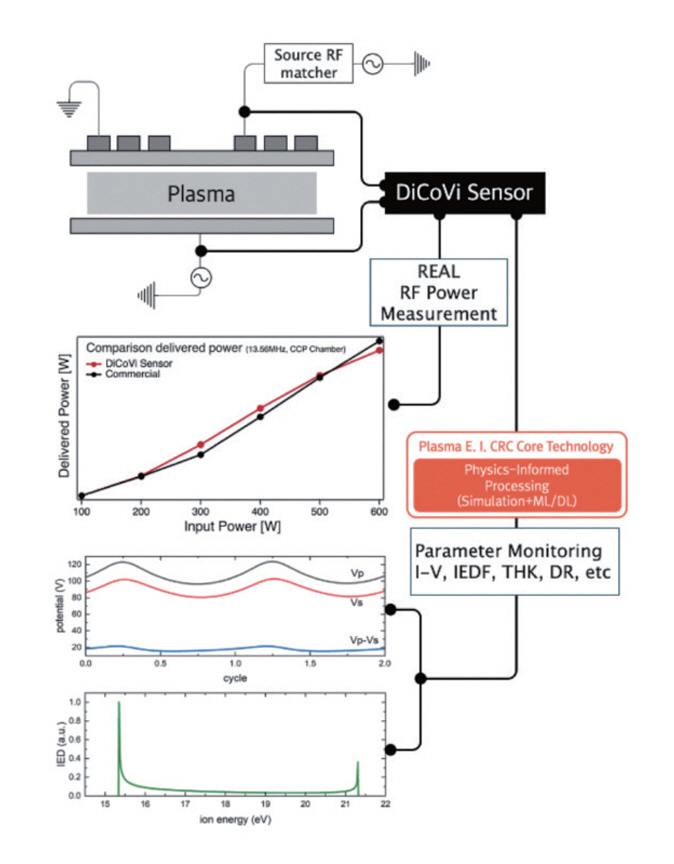
4.3 AI/ML 기반 예측 모델 개발
초미세 반도체 공정에서 필수적인 정확성과 생산 효율을 높이는 핵심 기술이다. 원자층 단위의 정밀한 식각을 위한 종말점 예측에 AI/ML을 적용하는 구체적인 방안은 다음과 같다.
ALE 공정은 옹스트롬(Å) 단위로 식각을 제어해야 하므로, 기존의 식각 종말점 검출 방식으로는 미세한 변화를 감지하기 어렵고, 공정 변수가 복잡하고 데이터 확보가 어렵기 때문에 AI/ML 기술 도입을 통하여 데이터의 상관관계를 파악해 최적의 종말점 예측 모델을 구축하는 것이 더욱 유리할 것으로 기대된다.
AI/ML은 공정 중 발생하는 미세한 이상 신호를 실시간으로 감지하고 예측해, 오버-에칭이나 언더-에칭 같은 문제를 사전에 방지함으로써 수율을 높일 수 있을 것으로 판단되며, 이를 구현하기 위한 핵심 기술은 다음과 같다.
4.4 ALE 공정 및 장비 지능화
플라즈마 장비의 지능화는 장비의 에지-보수와 고장-예측에도 중요한 역할을 한다. 센서 데이터와 기계학습 모델을 결합하여 장비의 상태를 지속적으로 모니터링하고, 잠재적인 문제를 사전에 식별함으로써 불시의 고장으로 인한 생산 중단을 최소화하고 유지보수 비용을 절감할 수 있다. 이러한 플라즈마 장비의 지능화 기술의 핵심은 센서(진단), 데이터 분석 및 처리, 인공지능 및 머신러닝, 시뮬레이션 기술 등 다양한 요소 기술들의 고도화가 필수적이며, 이러한 기술들을 통합하여 제조 공정 또는 장비의 효율성과 정확성 그리고 반복성을 극대화하는 것이다.
II. 특허 동향
1. 국내 출원 동향(출원 분야)
국내 기업, 연구소, 대학 가운데 주요 출원 기관은 기계연구원이 가장 많은 출원을 하였고, 이어 표준 연구원과 그 외에는 성균관대학교, 숭실대학교 등이 해당하고, 주요 출원 기업으로는 (주)이트론이 가장 많은 출원을 하였고, 그 외로 삼성전자와 (주)코리아스펙즈롤 프로덕트, (주)뉴-파워 플라즈마 등이 주요 출원 기관이다.
특허 분석 시 “원자층 에칭 공정 및 진단장치”를 키워드로 하여 분석한 결과, 1) 플라즈마 성분-질량분석을 통한 식각 선-폭 측정, 플라즈마 광-계측용 파이버 센싱, 2) 복수 개의 프로브(Probe)를 사용한 플라즈마 센싱, 고주파 안테나 구조를 사용한 플라즈마 진단, 3) 그 외 플라즈마 밀도 측정, 플라즈마 온도 측정, 4) 식각 공정 관련 질량분석, 아킹(Arching) 진단 및 플라즈마 밀도 측정 기술 등이 선진 기술 그룹이 출원하고 있는 분야로 나타났다.
국외 기술 그룹(기업 및 연구소, 대학) 가운데 주요 출원 기관은 Applied Materials Inc.와 Tokyo Electron Ltd.와 같은 반도체 공정장비 시장을 주도하는 출원인들은 모든 분야에 대하여 많은 출원을 하고 있는 것으로 나타난다. 단, 1) 오염 입자 감지 기술, 2) 원자층 에칭 속도 향상 분야에 대한 특허는 아직 출원이 많이 되지 않은 분야로 판단된다. 이러한 특허 포트폴리오는 중요하지만 아직 많이 출원되지 않은 분야와 향후 중점적으로 개발해야만 하는 분야를 매칭하여 연구 추진 방향을 설정하는 것이 필요해 보인다.
특허 분석 시, 핵심 키워드를 Plasma, APC(Advanced Process Control), VM(Virtual Metrology) 등으로 분석하였고, 선정된 키워드를 이용하여 Scopus 데이터베이스에서 검색한 후, 본 기술 분야별로 정리해 보면, 1) 반도체 공정 및 장비와 관련된 다양한 플라즈마 연구 논문의 경우에는 기술 이슈인 미세화 공정 기술 개발과 직접 관련된 특허 출원 건수는 많지 않았고, 2) 미세화 공정 기술 한계 극복을 위한 분야를 분석해보면 활발하게 출원되고 있는 것으로 나타났다.
핵심 기술 그룹별로 대표적인 국내외 연구 그룹의 특허 내용을 정리해 보면 표 1과 같다.
표 1 특허 분석 개요
1.1 플라즈마 공정 진단 시스템 & 종료점 검출 방법 및 장치-명지대학교
플라즈마 공정 진단 시스템 및 이에 있어서 종료점 검출 방법 및 장치 플라즈마 공정 진단 시스템은 플라즈마를 이용하여 증착 및 식각 공정 등을 수행하는 플라즈마 공정의 이상 유무 및 공정 상태 등을 진단하는 시스템으로서, 예를 들어 웨이퍼 식각 공정에서 종료점을 검출한다. 일반적으로, 상기 플라즈마 공정 진단 시스템은 상기 종료점을 검출하기 위하여 데이터의 기울기를 사용하며, 반도체의 크기가 큰 경우에는 상기 종료점을 정확하게 검출할 수 있다. 현재 반도체의 크기는 상당히 소형화되고 있는 추세이다. 그러나, 상기 데이터의 기울기를 이용하여 종료점을 검출하는 방법을 개방 비율이 낮은 (깊이 대비 개방 선-폭의 비) 에칭 공정에 적용하면, 광학 스펙트럼(OES: Optical Emission Spectroscopy) 크기가 너무 작아서 상기 종료점이 정확하게 검출되지 않는 문제가 있음. 즉, 종래의 진단 시스템은 플라즈마 공정의 이상 유무 및 공정 상태를 정확하게 검출할 수 없었다.
1.2 광학 스펙트럼(OES) 기반 에칭 종점 파악
식각 공정 시 식각 부산물에 의한 광 및 반응 가스 또는 분해된 원자나 분자에 의한 광(에천트, Etchant 의 파장)이 발생한다. 식각 부산물에 의한 광은 반응 가스와 반응하기 때문에 식각 공정이 진행될수록 감소되며, 그 결과 상기 식각 부산물에 해당하는 광의 파장도 공정이 진행되면서 감소한다.
반면에, 에천트는 식각 공정이 진행되면 반응 가스가 소모되므로 식각 공정 동안은 광의 강도가 약해지지만, 반응이 더 이상 일어나지 않으면 상기 반응 가스와 관련된 광의 파장의 피크는 다시 증가한다. 따라서, 상기 식각 부산물에 의한 광과 상기 에천트에 의한 광이 반대되는 특성을 가지므로, 하나의 광만을 이용하여 이후의 PCA를 적용한다. 여기서, 상기 광을 선택하기 위하여 다음의 수식 1과 같은 SNR을 이용한다.
여기서, A는 종료점 이전의 데이터이고, B는 종료점 이후의 데이터이며, S는 전체 데이터의 표준편차이다. 예를 들어, 종료점이 90초이면 A는 1초 내지 30초 사이의 데이터이고, B는 100초 내지 130초의 데이터일 수 있다. 이와 같이 SNR을 구하면, 광학 스펙트럼 분포를 가지는 그래프가 획득될 수 있다. 여기서, 0 이상의 값들은 식각 부산물에 의한 데이터이고, 0 이하의 값들은 에천트에 의한 데이터이다. 본 발명의 종료 지점 검출 방법은 SNR 그래프에서 기준값 이상의 파장만을 OES 데이터(Data)로서 선택한다. 예를 들어, 상기 종료점 검출 방법은 2.3 이상의 SNR을 가지는 데이터를 OES 데이터로서 선택할 수 있다.
2. 국외 출원 동향(출원 분야)
2.1 고장 검지 방법 및 플라즈마 처리 장치
임피던스 조정부의 고장을 검지를 통한 장비 이상 여부를 사전에 검지할 수 있는 기술 관련 특허가 활발하게 출원 중이다.
용량 소자 전압 MAX-값이 미리 정해진 역치보다도 큰 경우, 용량 소자는 쇼트되어 있지 않고, 정상이라고 판정할 수 있다. 한편, 용량 소자 전압 MAX-값이 미리 정해진 역치를 하회하는 경우, 용량 소자는 쇼트되어 있고, 이상이라고 판정할 수 있다. 예를 들어, 그림 3에는 역치를 도시하고 있지 않지만, 노이즈 등을 고려하여, 역치는 “0-볼트”보다도 크고 수 볼트 이하의 값이어도 된다.
측정한 전위 검출기(VC)에 대응하는(전위 검출기의 부근의) 임피던스 조정 회로의 용량은 쇼트되어 있고, 이상이라고 판정한다. 즉, 용량 소자 전압의 변화 유무에 의해 용량 소자(임피던스 조정 회로)의 정상 또는 이상 여부를 판정할 수 있다.
이상 여부 판정 방법
그림 3은 이상 여부 판정 방법을 도시하는 흐름도이다. 이 판정 방법은 스텝 S21에 의해 호출되었을 때에 개시된다. 즉, 기판(G)의 처리를 종료했다고 판정한 경우, 그림 3에 이상 판정 방법의 실행 과정을 개시하였다. 이때 이상 검지 판정부는, 모든 임피던스 조정 회로의 판정을 완료했는지를 판정한다.
스텝 S19이 처음 실행되었을 때 ‘아니오’라고 판정되므로, 스텝 S09로 진행하고, 이상 검지 판정부는 미판정의 임피던스 조정 회로의 용량 소자 전압 최댓값이 미리 정해진 역치 이상인지를 판정한다. 여기서 말하는 용량 소자 전압 최댓값은, 용량 소자 전압 최댓값의 절댓값이다.
스텝 S19에 있어서 이상 검지 판정부는 용량 소자 전압 최댓값이 미리 정해진 역치 이상이라고 판정한 경우 스텝 S17로 진행하고, 그 임피던스 조정 회로는 정상이라고 판정한다. 기억부는 테이블의 판정 플래그 중, 해당 임피던스 조정 회로에 대응한 판정 플래그에, 정상을 나타내는 ‘0’을 기억하고, 스텝 S19로 되돌아간다. 스텝 S19에 있어서 이상 검지 판정부는 용량 소자 전압 최댓값이 미리 정해진 역치를 하회한다고 판정한 경우 스텝 S21로 진행하고, 그 임피던스 조정 회로는 이상이라고 판정한다. 기억부는 테이블의 판정 플래그 중, 해당 임피던스 조정 회로에 대응한 판정 플래그에, 이상을 나타내는 ‘1’을 기억하고, 스텝 S13으로 되돌아간다.
스텝 S21에 있어서 이상 검지 판정부는 모든 임피던스 조정 회로에 대응하는 용량 소자 전압 최댓값의 판정을 완료하였다고 판정할 때까지 위 과정을 반복한다. 이상 검지 판정부는 모든 임피던스 조정 회로의 판정을 완료하였다고 판정한 경우, 임피던스 조정 회로마다 전체 처리 스텝의 판정 플래그를 추출한다.
2.2 플라즈마 처리 장치, 플라즈마 상태 검출 방법 및 플라즈마 상태 검출 프로그램
플라즈마 챔버 내에 센서를 배치하지 않고 플라즈마 상태를 검출하는 기술을 제공한다. 일반적으로 플라즈마 챔버 내에 각종 프로브나 각종 전기 센서 등의 센서를 배치하여, 플라즈마의 상태를 검출할 수 있다.
그러나 처리 용기 내, 특히 플라즈마 생성 영역에 가까운 장소에 센서가 배치되면, 첫째, 센서의 영향에 의해 플라즈마의 상태가 변화해버린다. 그러면, 플라즈마 처리 장치에서는, 피-처리 막에 대한 플라즈마 처리의 특성이나 균일성 등에 영향이 발생할 우려가 있다. 둘째, 플라즈마 처리 장치에서는 파티클이나 이상 방전이 발생할 우려도 있다. 셋째, 피-처리 막에 대하여 플라즈마 처리를 실행할 수 없는 경우가 있다. 그러면, 플라즈마 처리 장치에서는, 실제로 플라즈마 처리를 실행하고 있는 도중의 플라즈마의 상태를 검출할 수 없기 때문에 처리 용기 내에 센서를 배치하지 않고 플라즈마의 상태를 검출하는 연구가 진행 중이다.
2.3 센서 없이도 플라즈마 상태를 측정하는 방법
플라즈마가 존재하지 않는 경우, 웨이퍼(Wafer)의 온도는 위치와 관계없이 일정한 값을 가진다. 플라즈마 발생하면 플라즈마에 의한 열 발생으로 히터의 전력은 플라즈마가 존재하지 않는 경우보다 히터로 공급되는 전력을 감소시켜 일정한 온도를 유지한다. 또한, 플라즈마의 밀도가 중앙에서 크고 가장자리로 갈수록 작아지는 경우, 밀도에 비례하여 열-발생이 증가한다. 따라서 히터로 공급되는 전력은 중앙에서 작고 가장자리로 갈수록 증가한다.
따라서 플라즈마의 존재 여부와 플라즈마 밀도 상태에 따라 각 존(Zone)에서 히터로 공급되는 전력을 계측하고, 존별 계측 결과를 사용하여 각 존에 공급되는 열량을 구할 수 있다. 그리고, 각 존의 열량으로부터 플라즈마의 밀도 분포를 구할 수 있다. 즉, 실시 형태에 따른 플라즈마 처리 장치는 처리 용기 내에 센서를 배치하지 않고도 플라즈마의 상태를 검출할 수 있다.
2.4 원자층 에칭(ALE)용 종점 검출 알고리즘
깊이 대비 좁은 개방-선폭을 가지는 에칭 공정의 경우, 기존의 광-방출 스펙트럼(OES)을 사용한 에칭 종점 파악은 스펙트럼 변화가 크지 않아서 에칭 종점 파악이 어렵다. 따라서 깊이 대비 좁은 개방-선폭을 가지는 낮은 개방 비율의 에칭 공정에 대하여 종점 위치에서 보다 큰 스펙트럼 변화를 유도할 수 있는 알고리즘 개발을 통해 플라즈마 에칭 종점을 정밀하게 파악하고자 한다.
플라즈마 에칭 처리 시스템에서 주기적으로 반복되는 다중 프로세스 단계의 종점 검출을 위한 예시적인 프로세스를 도시한 것으로서, 블록에서, 이전에 계산되고 저장된 평균 광학 방출 분광학(OES) 데이터 매트릭스 [Savg]를 제공한다. 블록에서, 이전에 계산되고 저장된 주 구성요소 가중 벡터 [P]를 제공한다.
블록에서, 주기적 다중-단계 플라즈마 프로세스 동안 소정의 시간 간격으로 소정의 프로세스-단계로부터 광학 방출 분광학(OES) 데이터 세트를 형성하는 단계가 수행된다. 블록에서, 각각의 광학 방출 분광학 데이터 세트로부터, 이전에 제공된 평균 광학 방출 분광학 데이터 매트릭스 [Savg]를 빼서 각각의 광학 방출 분광학 데이터 세트를 감축(De-mean) 하게 된다.
블록에서, 제공된 주 구성요소 가중치 벡터 [P]를 이용하여 변환된 광학 방출 분광학 데이터 벡터 [T]의 적어도 하나의 요소를 계산함으로써, 각각의 감축된 그리고 비-정규화된 광학 방출 분광학 데이터 세트를 변환된 광학 방출 분광학 데이터로 변환한다. 블록에서, 그리고 변환된 광학 방출 분광학 데이터 벡터 [T]의 계산된 적어도 하나의 요소로부터, 트렌드 변수 f(Ti)를 또한 계산한다. 블록에서, 주기적인 다중 단계 플라즈마 프로세스 동안 트렌드 변수 f(Ti)의 계산된 값들로부터 주기적 다중 단계 플라즈마 프로세스의 제1 종점을 검출한다.
III. 결론
플라즈마 변수를 직접 측정하고 분석하여 공정을 제어하거나 예측하는 기술 개발이 매우 빠르게 진행되고 있으며, 더욱이 인공지능 기술을 사용한 장비 지능화 기술에 대한 가속화되고 있는 시점이다. 따라서 본고에서는 최근 핵심 이슈 가운데 하나인 AI 기술을 접목한 ALD 공정 및 장비 지능화를 구현하기 위한 개발 방향을 분석하였다. 또한, 원자층 식각 공정 및 장비 지능화 기술에 대한 연구 및 특허 동향 분석을 통하여 차세대 ALD 기술 구현을 위한 추진 방향을 검토하였다.
ALD 공정의 공정 속도를 개선하기 위해서는 마이크로웨이브 열처리기 등을 사용하여 복수의 마이크로웨이브 공급기 각각을 독립적으로 구동하여 각각의 마이크로웨이브 공급기의 마이크로웨이브 발생 패턴을 제어기를 통하여 열처리를 수행하여 에칭-속도를 올리는 등의 연구가 필요할 것으로 보인다.
고주파(300MHz 이상) 가열에 마이크로웨이브열 처리기는 마그네트론에 의해 발생한 마이크로웨이브 에너지를 직접적이든, 중간의 웨이브 가이드(Wave Guide)를 이용하든, 가공처리 할 물체를 담는 챔버(Heat Chamber)에 전달한다(그림 4). 보다 더 균일한 가열을 얻기 위하여 회전하는 접시나 선풍기 모양을 한 히터 배치에 대한 설계 및 마이크로웨이브 패턴 설계, 복수의 마이크로웨이브 열처리기를 배치하는 챔버 설계 등 다양한 방법이 가능할 것으로 추측된다.
마이크로웨이브 제어기를 도입하여 각각의 마이크로웨이브 공급기의 출력을 높일 수도 있으며, 작동하는 마이크로웨이브 공급기의 수를 늘려서 열처리를 위한 가열 속도를 높임으로써 원자층 식각 속도를 개선하는 연구가 가능할 것으로 예측된다.
마이크로웨이브를 사용한 가열 방식은
• 제품만이 가열되기 때문에 에너지가 절약된다.
• 콤팩트한 장비가 에너지를 절약한다.
• 가공라인에서 “가열”이라는 제한적인 요인이 제거된다.
• 유연한 모듈 단위의 설계
• 지능적인 서비스와 유지관리 개념으로 신뢰할 수 있고,
• 친환경적이라는 점 등의 다양한 장점을 가진다.
용어해설
Nanopiezotronics 나노선/나노튜브와 같은 1차원 압전 나노 소재의 압전성과 반전도성의 coupling을 이용한 새로운 나노 전자/에너지 소자 기술
머신러닝 컴퓨터가 데이터를 통해 스스로 학습하고 패턴을 발견하여, 명시적인 프로그래밍 없이도 예측이나 결정을 내릴 수 있게 하는 인공지능(AI)의 한 분야. 더 많은 데이터를 학습할수록 성능과 정확도가 향상됨
에지보수 최근 정보통신기술(ICT) 및 스마트 팩토리 분야에서는 ‘엣지(Edge)’가 데이터가 생성되는 현장 또는 최종 사용자와 가까운 네트워크의 끝단을 의미
A. Mesbah and D. B. Graves, "Machine learning for modeling, diagnostics, and control of non-equilibrium plasmas," J. Phys. D: Appl. Phys., vol. 52, 2019, p. 30LT02.
K. J. Kanarik et al., "Human–machine collaboration for improving semiconductor process development," Nature, vol. 616, 2023, pp. 707–711.
S. Park et al., "Application of PI-VM for management of the metal target plasma etching processes in OLED display manufacturing," Plasma Phys. Control. Fusion, vol. 61, 2018, p. 014032.
S. Park et al., "Micro-range uniformity control of the etching profile in the OLED display mass production referring to the PI-VM model," Phys. Plasmas, vol. 28, 2021, p. 103505.
그림 2
각종 센서의 측정 기능 및 공정 흐름도[4]
출처 Reprinted with permission from 윤정식, “플라즈마장비 지능화기술,” Vacuum Magazine, 2024. 3.
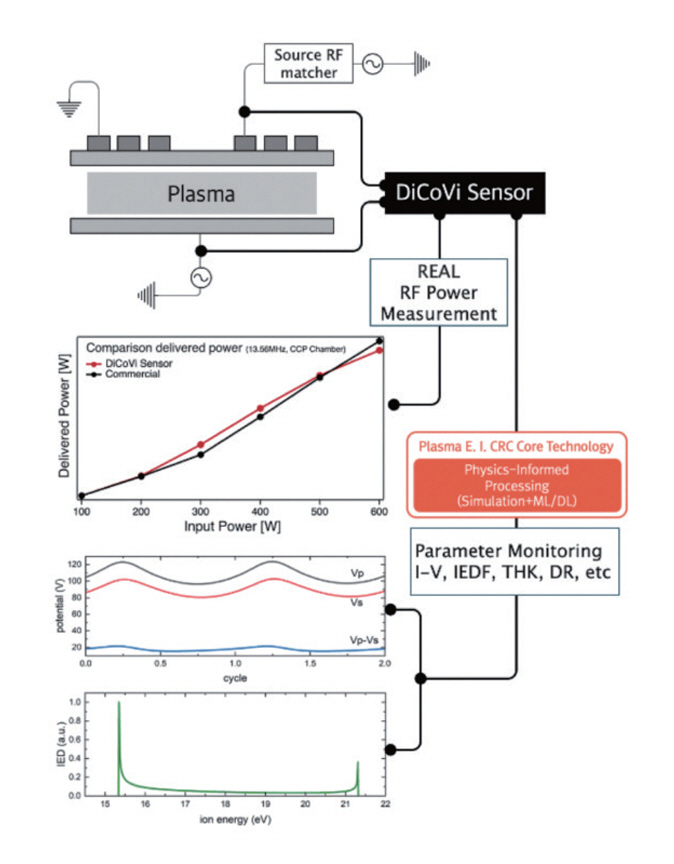
- Sign Up
- 전자통신동향분석 이메일 전자저널 구독을 원하시는 경우 정확한 이메일 주소를 입력하시기 바랍니다.